
随着集成电路尺寸不断缩小,传统的铜(Cu)互连因电阻尺寸效应严重而面临严峻的性能挑战在10纳米线宽下,铜互连的电阻率可达块体材料的数十倍,严重制约芯片性能提升。寻找新一代互连金属及其加工方案成为行业迫切需求。Ir(铱)、Ru(钌)、Rh(铑)等金属因其电阻尺寸效应较弱、可靠性好,被称为有望取代铜的“下一代互连金属”。然而目前下一代互连金属材料的加工方案尚不成熟。
在此背景下,上海科技大学物质科学与技术学院冯继成课题组成功开发出用于下一代芯片金属互连“自下而上”增材加工的新方案。相关研究成果以题为“Wafer-scale nanoprinting of 3D interconnects beyond Cu”发表于国际学术期刊ACS NANO, 并被选为增选封面(Supplementary Cover)。


本工作中,课题组开发了不受材料限制,且兼具纳米级加工精度与晶圆级加工通量的新型金属互连方案,利用其加工的Au、Ir与Ru三维金属互连可达到理论预测的导电性能。该方法利用“人工闪电”创制等离子体氛围下的金属纳米颗粒,通过气流将其携带进入预设构型的空间电场中,将纳米颗粒原位打印成高纯、多级、多材料、高精度和晶圆级的3D纳米互连结构,最小三维结构的特征尺度已至17 nm(图1)。
除纳米级加工精度外,该策略兼具低成本的优势,相较于主流大马士革工艺(绝缘层刻蚀– Cu填充–平坦化)的金属互连制造方案,可节省3个量级能源消耗和提高5个量级的材料利用率(图1)。

图1.晶圆级大面积3D打印多级、多尺度、多材料的芯片互连结构。
通过程控化定制电场空间构型,该工作中成功打印了不同尺度的Ru、Ir和Au材料的互连结构,并展示了“台阶式”的三维互连,为未来芯片立体集成提供了可行方案(图2)。
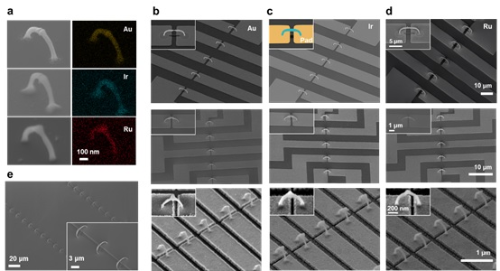
图2.打印互连结构的材料和尺度的灵活调控以及台阶式互连结构。
互连的电学性能与其构型同样重要。实验结果表明,经过简单热处理后,打印金属互连结构展现出接近理论预测值的导电性能,这为未来芯片三维互连的实际应用具有重要意义。

图3.打印互连结构的性能优化以及理论预测。
此外,为契合集成电路的产量需求,本工作中还开发了一种基于脉冲电场的高通量打印策略,实现了晶圆级规模化制造金属互连结构,仅需单次打印即可在1小时内加工超千万个3D纳米结构(图4)。所打印的互连结构展现出优异的一致性,其尺寸变异系数CV <10%,与光刻图案CV在一个量级,满足集成电路的要求。
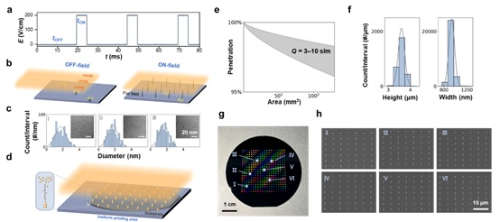
图4.基于脉冲电场的晶圆级高通量打印。
简单来说,该工作展示了打印三维纳米结构作为芯片互连的应用潜力,有望为受制于现有制造手段而难以实现的芯片互连方案带来新的发展机会。
与此同时,该技术不仅适用于集成电路互连制造和金属化,在MEMS、光学超构材料等前沿领域同样展现出广阔的应用前景。
• 科研进展|上科大物质学院冯继成组在Advanced Materials发表后封面成果:4D打印彩色微电影
• 物质学院冯继成课题组自研“电力线画笔”高速描绘多材料、高精度的三维纳米结构阵列
• 科研进展|上科大物质学院冯继成组的最新成果荣登背封面:电饭煲蒸笼模型也能3D打印阵列金属纳米结构
• 物质学院冯继成课题组发表邀请综述:从3D纳米打印到原子制造
冯继成团队将持续深耕纳米尺度3D打印技术的基础和应用研究,重点推进该技术与现有芯片制造工艺的深度融合,致力于攻克制约我国集成电路产业发展的卡脖子技术难题,为提升我国在高端芯片制造领域的自主创新能力注入新动能。
欢迎扫码 关注我们



